
KR101484568B1 - High etch-resistant carbon hard mask condensasion polymer and anti-reflection hard mask composition including same, and pattern-forming method of semiconductor device using same - Google Patents

Alpha Carbon Hardmask in 3D-NAND Device Manufacturing Characterization by Multiple Metrology Methods for In-Line Control of High Aspect Ratio Etching - Onto Innovation
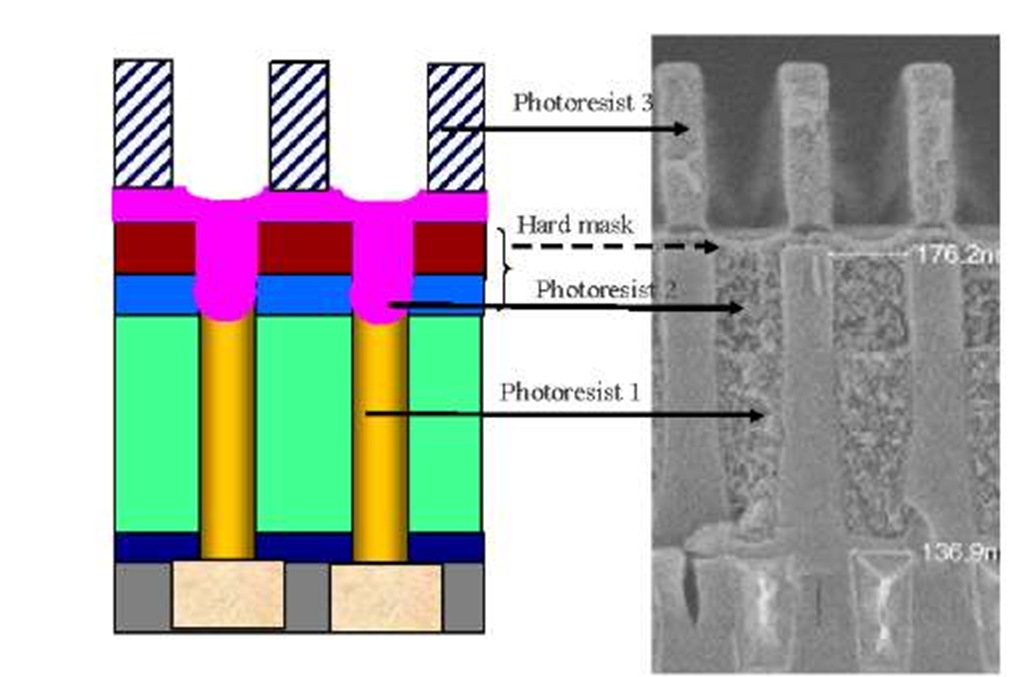
Integrated process feasibility of hard-mask for tight pitch interconnects fabrication (MEMS and Nanotechnology)

Conversion of a Patterned Organic Resist into a High Performance Inorganic Hard Mask for High Resolution Pattern Transfer | ACS Nano

KR20160110657A - Polymer for hard mask, hard mask composition including the polymer, and method for forming pattern of semiconductor device using the hard mask composition - Google Patents
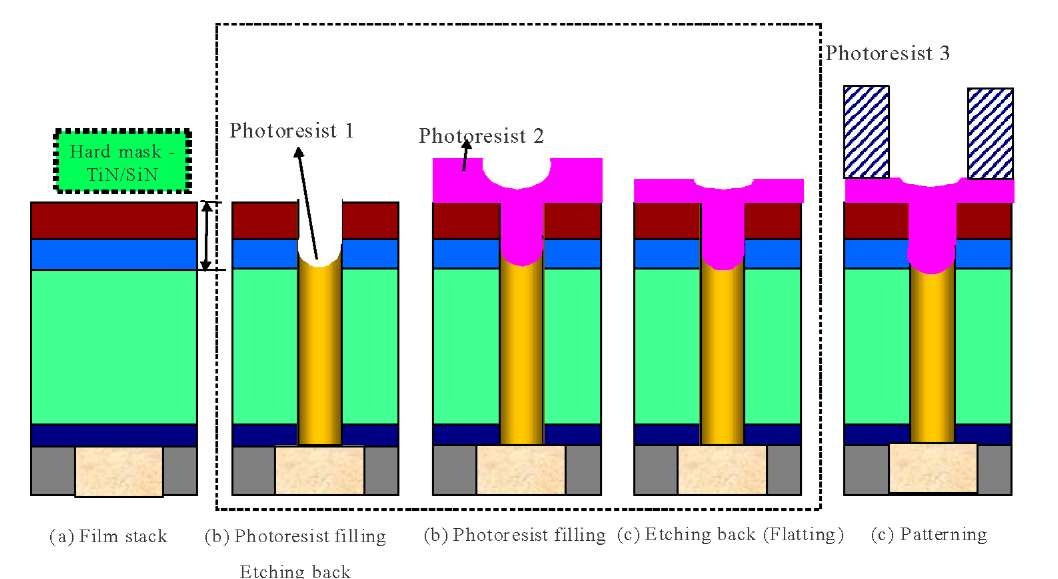
Integrated process feasibility of hard-mask for tight pitch interconnects fabrication (MEMS and Nanotechnology)

Etching characteristics of TiN used as hard mask in dielectric etch process: Journal of Vacuum Science & Technology B: Microelectronics and Nanometer Structures Processing, Measurement, and Phenomena: Vol 24, No 5

BALD Engineering - Born in Finland, Born to ALD: Applied Materials Introduces Materials Engineering Solutions for DRAM Scaling

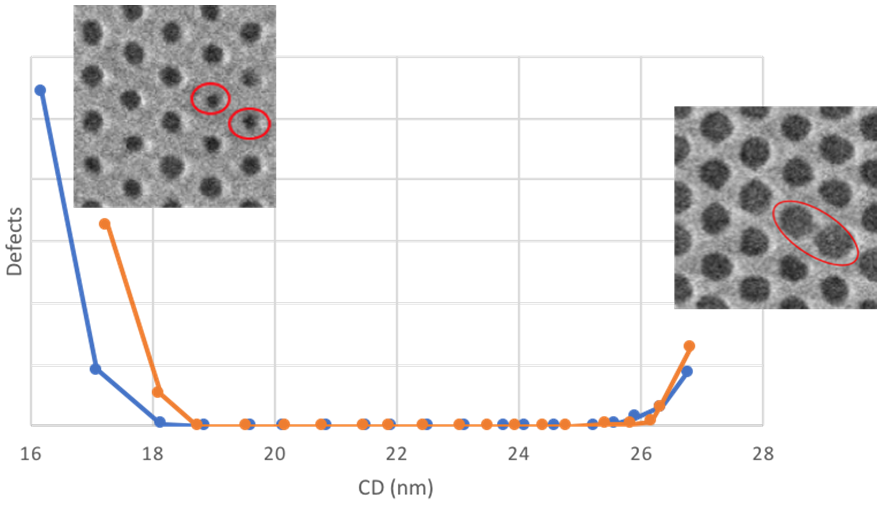
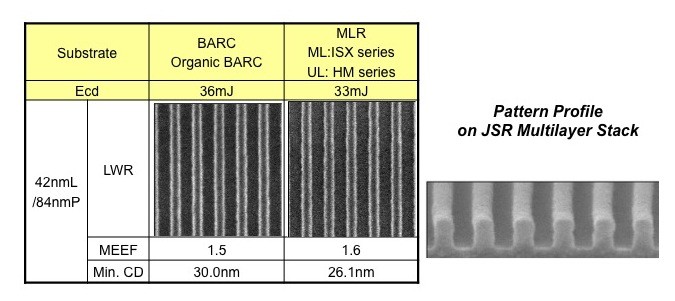
![PDF] Chromium oxide as a hard mask material better than metallic chromium | Semantic Scholar PDF] Chromium oxide as a hard mask material better than metallic chromium | Semantic Scholar](https://d3i71xaburhd42.cloudfront.net/56b1bb76acd51804dcf35a31d1cbcb20934471f3/3-Figure1-1.png)